アプリケーション
マッピング測定事例
測定事例 1. 100nmのSi3N4の厚みと屈折率測定

データ解析に使用された光学モデルには、Siウェハー基板上の2nmの酸化膜と、透明Si3N4膜を表す「Cauchy」層で構成されています。
マッピング結果は以下の等高線と3Dプロットで表示することができます。
等高線では、公称100 nmの膜厚範囲のとおり、ほぼ5 nm以内に収まっていることがわかります。
3Dプロットは、膜厚の不均一性が最も視覚的にわかりやすくなるように回転させたものです。


測定事例 2. 複数層厚の測定:SiO – SiN – SiO膜(ONO)サンプル
多層膜の解析では、通常、各単層膜の光学定数を事前に測定する必要がありますが、現場ではそれが困難なケースも少なくありません。こうした課題に対し、FS-RT300のマルチサンプル解析が効果を発揮します。
本事例では、FS-RT300を使用して、1枚のウエハー上に十字状で29点を設定し、それぞれを厚さの異なるサンプルとして解析を実施。事前測定を行わずに、3層構造(SiO – SiN – SiO膜)の膜厚と屈折率を高精度で導き出すことに成功しました。
3層それぞれの膜厚マッピング結果は、以下の等高線および 3D プロットに示しています。
中間層の窒化物は他層と異なる分布を示し、酸化物層同士には類似した膜厚パターンが確認されるなど、層ごとの特徴を明確に視覚化・定量化できました。
FS-RT300は、わずか1枚のウエハーから多層膜構造の詳細な情報を引き出し、従来の制約を超えた次世代の解析手法を提供します。
.jpg)
2.jpg)
測定事例 3. 100nmのHfO2膜
透明なコーシー層を仮定した初期モデルでフィットした結果、Fit Diffは0.0116とやや高い値でしたが、Cauchy層の 消衰係数「k 」項をフィッティングして膜中の吸収を許容することで、Fit Diffは0.002まで大幅に減少しました。
ウェハーマップは、膜厚が5nm程度変化するのに対し、膜のnとkの値は比較的一定であることを示しています。
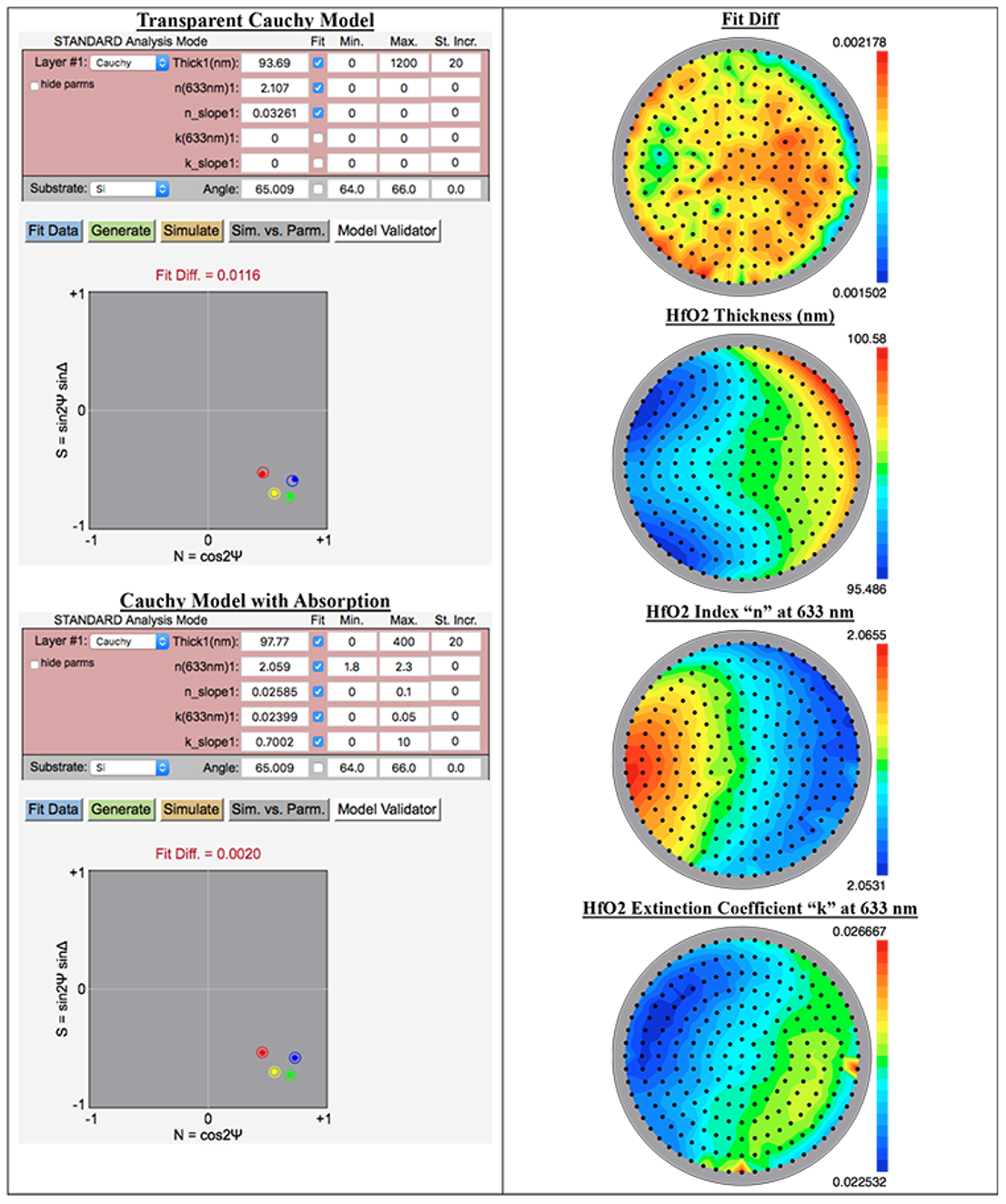
Si上のHfO2 (1.8nmと4.7nm)を測定した際に、以下の光学モデルを用いました。Si基板の自然酸化膜厚を1.5nmと仮定し、既知のHfO2の光学定数を使用したところ、モデルフィット・膜厚均一性ともに良い結果が得られました。

測定事例 4. 超格子膜の測定
異なる組成の超薄膜が周期積層構造をとっている半導体超格子膜においても、FS-RT300を使用して組成ごとの周期膜の平均膜厚を求めることができます。


