マルチスペクトル・エリプソメーター 全自動マッピングシステム(FS-RT300)
8波長の最新LED光源で様々なサンプルに対応

LED光源と特許所得技術で、
高精度かつ簡便なエリプソメトリー解析を実現
FS-4 / FS-8が採用するマルチLED光源と特許取得のMWE技術
特許取得(米国特許番号:9,354,118)のMWE(Multi-Wavelength Ellipsometer)技術とマルチ波長のLED光源を使用することで、 ワイドなスペクトルを持つエリプソメトリー解析が可能です。
FS-RT300は、最新スペックのFS-8(G4)と同じ8波長のLED光源を搭載し、0~5µmの薄膜測定を提供します。光源ユニットの光学経路は、マルチスペクトルのLED光源を明るく均一な1筋の光へと統合されます。
FS-RT300の主な機能と特長は下表の通りです。
| 主な機能 | 特長 |
|---|---|
| マルチLED光源 (370~950nmの波長範囲から8つの光源) | 長寿命(50,000時間以上)で、装置のご利用期間中にLED光源やそれに伴う光軸校正をする必要はありません |
| 特許取得のMWE技術により、検出器に可動部位なし | ・分光エリプソ以上の高い再現性精度を実現 ・最短1.7ミリ秒の高速測定が可能 ・分光エリプソに必要な定期的な校正は不要 |
| 高い再現性精度を実現 | ・厚さ0~5μmの膜厚測定 ・Si基板上の自然酸化膜をデータ取得レート1秒で測定時、0.001nmの精度で測定可能 |
| PCを内蔵しWebブラウザから制御可能 | 複雑なソフトウェアのセットアップや メンテナンスが不要 |
最大8波長!広いスペクトル範囲の測定で強化された薄膜測定
FS-RT300は、より多くの波長とより広いスペクトル範囲で、強化された薄膜測定を提供します。 新しいシステムは、使いやすさと手頃な価格を維持しながら、特許取得済のMWE(Multi-Wavelength Ellipsometer)技術と長寿命LED光源、高速でかつ高い再現性を実現した可動部のない検出器、コンパクトデザイン、Webブラウザーインターフェイスを提供します。
| スペクトル範囲 | 370 ~ 950 nm |
| 波長数 | 8 |
| 特長 | ・UV波長(370 nm)は、10 nm以下の非常に薄い膜やポリマー膜の 測定感度を向上させます ・3つの長波長(735, 850, 950 nm)は、厚い透明膜(最大5μmまで)や半導体吸収膜(ポリ-Si、SiGe、アモルファス-Si等)の測定を可能に |
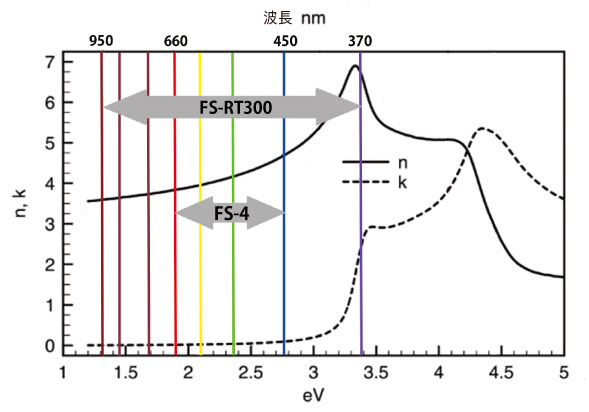

オングストローム・ナノ薄膜の膜厚を高精度計測
サブモノレイヤーからナノ薄膜の膜厚を高精度計測
多層膜も非破壊で各層の膜厚計測を実現
マルチスペクトル・エリプソメーターは薄膜に対して非常に高感度で、エリプソメトリックな(Δ:デルタ、ψ:プサイ)、パラメーターに由来しています。
サンプルに反射したp 偏光とs 偏光間の位相を測定することで、測定する光の波長(500nm)が
膜の厚さ(0.1nm未満)に比べて非常に長くても、サブモノレイヤーの厚さに至るまで正確な膜厚の定量値を計測します。
下記の表は多層膜を含む様々なサンプルを用いた標準測定での正確性と精度を示しています。
MWE技術により、膜厚0Å~1000nmの範囲の薄膜を対象とした膜厚と屈折率の測定に優れています。

”新技術” 「Fast Mode」
最速1.7ミリ秒の超高速ダイナミックエリプソメトリー測定!
従来のエリプソメーターも10ミリ秒での高速測定が可能でしたが、新機能の「Fast Mode」により、測定波長数を減らし、3.2ミリ秒/波長数(暗部補正なしにすると1.7ミリ秒/波長数)での超高速測定を実現しました。in situ測定で、さらにリアルタイムな測定を可能にします。
(Gen3以降のマルチスペクトル・エリプソメーターが対応します)
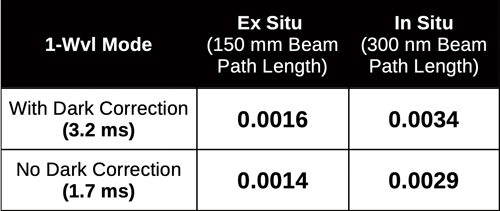
簡単測定&Model Builder自動解析搭載
簡単操作で様々なサンプル測定が可能
通常は3つのモードで簡単に膜厚測定から解析・解析結果の検証ができます。
解析モードでは、エリプソメトリックデータの解析結果を可視化と数値化しますので簡単に解析評価が可能です。 また、光学データにより、解析結果の検証が可能になります。
様々なサンプル解析を
FilmSenseのソフトウェアには、様々な素材の光学定数ライブラリがインストールされています。Cauchy、Tauc- Lorentz、Drudeモデルなどの誘電関数モデルも搭載されており、サンプルの光学特性に応じた解析が可能です。また、Bruggemanの有効媒質近似(EMA)を用いた、表面ラフネスや混合層の解析も可能で様々なサンプルを高精度に膜厚評価ができます。
”新機能” 自動モデル構築機能「Model Builder」
サンプル材質と積層情報を入力すると解析パラメーターを瞬時に提案
Model Builderを使用することで、各パラメータをAIが自動的に解析し、最適フィットモデルを表示します。最適フィットモデルをベースに、今まで通り独自にパラメータを調整することもできます。
複雑な作業を高速で完了できますので、ぜひご活用ください。
ルーチーンはワンクリック測定

シングル測定モードでは、サンプルセットした後、ワンクリックするだけで簡単にサンプルを測定できます。
簡単に解析モデルを作成可能
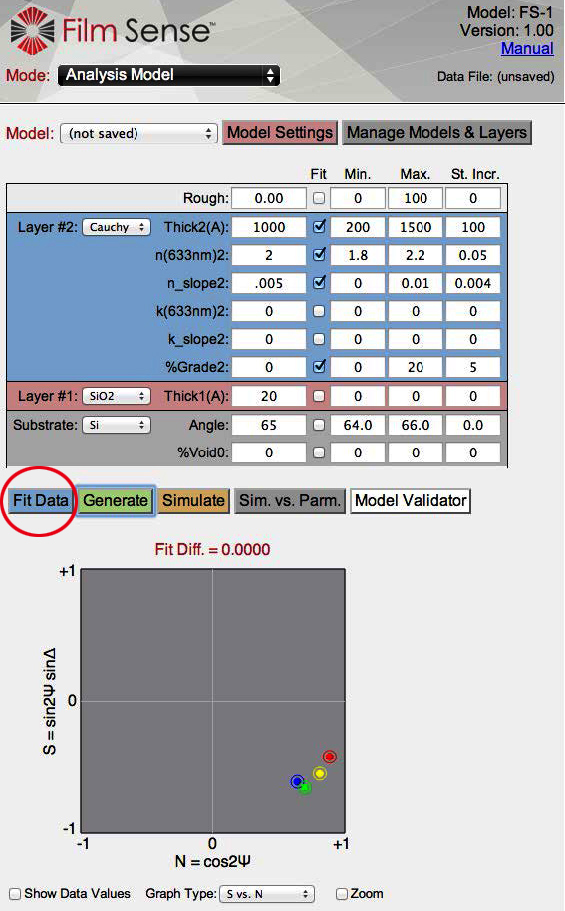
解析モデルモードでは、エリプソメトリック測定データを解析して視覚化するための強力な機能が提供されます。
光学モデルバリデータ搭載
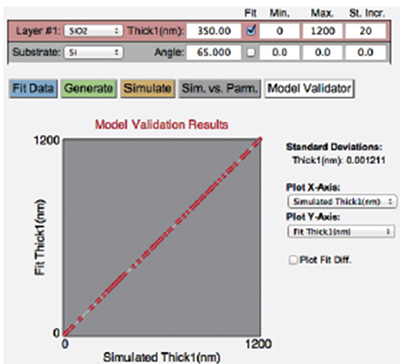
光学モデル検証ツールは、すべてのモデル適合パラメータが指定された範囲に一意に収束することを検証します。
解析モデルの特長
・標準解析、in situ マルチレイヤー、マルチサンプル、軌跡(ΔとΨの変化)、および表面近傍データ解析モード
・最大 10 のモデル レイヤー、オプションの表面粗さ、および基板裏面反射補正
・パラメーターの範囲と開始増分により、パラメーターの収束の適合性が向上します。
・混合マテリアルおよびグレーデッド インデックス レイヤーに対するBruggeman有効媒体近似法。
・Cauchy、Sellmeier、Lorentz、Drude、Tauc-Lorentz、および Multi-Osc 分散モデル。
・温度または組成に依存する光学定数ライブラリ ファイル。
・偏光解消または透過強度データを多波長データ解析と組み合わせることができます。
・単一の測定または動的データをシミュレートし、Fit Diff とパラメーター値をプロットします。
・適合パラメーターの 90% 信頼限界と相関行列を表示し、パラメーターの精度を推定します。

日常的なサンプル測定が簡単に行えます。